×

×

 ×
×
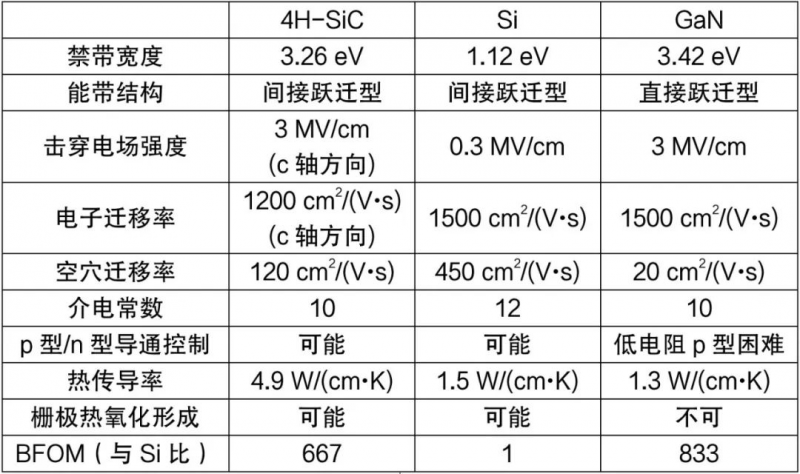
表1:SiC和Si、GaN的物理特性对比
比较功率器件不同材料的性能时,通常使用性能指数BFOM(Baliga’s Figure of merit)。BFOM与理想单极型器件的电阻成反比,可通过以下公式计算。

(公式1)

(公式2)
ε:介电常数;μ:迁移率;EBD:击穿场强;R:器件电阻;VBD:器件的击穿电压;
由于BFOM与击穿电场强度的三次方成正比,而SiC的数值是Si的10倍,这有利于实现低电阻单极器件。根据表中数值,与Si相比,SiC单极性器件的电阻有可能降低至Si的1/667。此外,电阻与器件击穿电压的平方成正比,因此对于高耐压(额定电压),单极性器件的电阻会急剧增加。所以,使用Si材料来实现千伏级耐压的单极性器件并不现实,因为电阻过大,但可以通过使用SiC来实现。SiC器件的主要目标就在中高压领域,三菱电机率先使用SiC实现了千伏级单极性器件,为包括铁路牵引系统在内的许多电力电子系统带来了革新。
关于SiC物理特性的各向异性,在制造器件时需要考虑几个问题。4H-SiC的击穿电场强度在(0001)方向(衬底厚度方向)的值比其他方向大。对于体电子迁移率,(0001)方向也比其他方向大。另一方面,比较采用SiC各晶面制造的MOS结构的沟道迁移率,(0001)面的值较小,而垂直于(0001)面的值较大,这意味着,与在(0001)面制造的平面栅MOS相比,沟槽栅MOS的沟道电阻更低。
存在于SiC MOS界面的载流子捕获,它是SiC MOSFET特性不稳定和经时变化的原因,目前改善措施正在进行中。三菱电机已开发出一种可提高稳定性的MOS界面形成方法,实现了MOS特性的稳定性。
热氧化膜的生长速度也因晶面的不同而存在很大差异,例如,(000-1)面的氧化速度约为(0001)面的10倍。在器件制造过程中,需考虑到氧化速度的各向异性,并根据结构对制造工艺做出相应的处理。
宽禁带半导体通常难以实现两种导电方式,要么p型导电,要么n型导电。尽管SiC是一种宽禁带半导体,但它是少数几种可制造出p型和n型高载流子浓度的材料之一。通常,用于n型半导体导电性控制的掺杂是V族元素的氮、磷,而用于p型半导体导电性控制的掺杂是III族元素的铝、硼。关于硼,由于受主能级较深,无法获得低电阻p型半导体,因此常用在保持器件耐压的终端区域。此外,与Si等材料相比,由于SiC的晶体结构较为复杂,掺杂原子取代的位置不同会导致形成的能级不同。在推导载流子迁移率、估算电阻值的温度依赖性等方面,严格来说需要考虑这一点,但在估算器件特性时,使用平均值并没有问题。
SiC作为功率器件材料的另一个优点是其热导率高(约为Si的3倍)。这一优势得益于SiC原子间距短、键合力强,有助于降低器件工作时的最高温度。此外,即使在高达800℃的温度下,SiC仍能保持其半导体特性。目前,除SiC外的其他材料,使用温度的上限受到限制,仍在继续开发中。
另外,在将SiC应用于功率芯片时,需考虑SiC材料的特性,其杨氏模量较大(约为Si的3倍),是一种非常硬的材料,因此受温度循环等因素产生的应力可能会非常大,这可能成为决定器件寿命的主要因素。